CVD・ALD材料
CVD・ALD材料是什么?
CVD材料是将带有蒸汽压的原材料进行气化,在各种条件下利用气相中的化学变化,对目标物质进行成膜的材料。
层间绝缘膜的生产材料
在硅半导体用的液体CVD材料之中,现在普遍使用的金属有机化合物有TEOS,TMB, TEB,TMP,TMOP以及TEOP等。
TEOS是目前用于半导体元件数量最多的CVD材料,我们是生产和供应TEOS的先驱,并且对与TEOS同样被频繁使用的以TEOP,TEB等材料为首的各种CVD材料进行生产。

CVD材料普遍用气缸进行供应。
可根据使用量及装置的规格对气缸进行设计和生产。
| 简称 | 化学式 |
|---|---|
| TMB | B(OCH3)3 |
| TMP | P(OCH3)3 |
| TEB | B(OC2H5)3 |
| TEOS | Si(OC2H5)4 |
| TMOP® | PO(OCH3)3 |
| TEOP® | PO(OC2H5)3 |

在供应少量醇盐和卤化物的方面,玻璃制的安瓿瓶是最常用的容器。
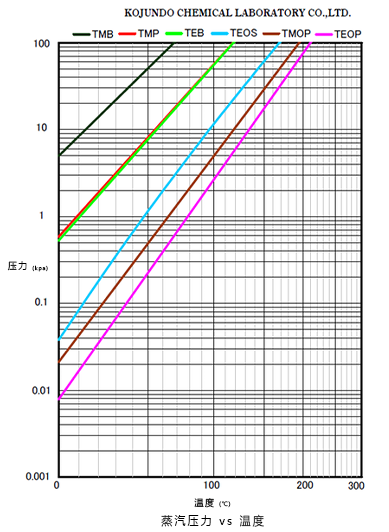
ALD用材料
ALD(原子层沉积)是一种将氮化膜或氧化膜以单原子膜的形式一层一层的镀在基底表面的方法。
通过这种方法可以对10nm厚度薄膜进行安定的生产。
作为其材料,使用与氧化剂有着高反应,例如金属醇这种通过自身的热分解,不易产生氧化膜的物质是最适合的。
氮化膜适用于栅极绝缘膜及阻挡膜的成膜,一般使用金属酰胺,酰亚胺,金属氯化物。
金属酰胺的化学式为M-NR1R2,金属酰亚胺为M=NR,金属氯化物则是化学式为MCIx的化合物。
一般常用的有TEMAZ,TDMAH,TBTEMT,ZrCl4,WCl6,AlCl3。

主要用在ALD上的酰胺类化合物的性质
| 简称 | 化学式 |
|---|---|
| 3DMAS | SiH[N(CH3)2]3 |
| TDMAH | Hf[N(CH3)2]4 |
| TEMAZ | Zr[N(C2H5)CH3]4 |
| Taimata® | Ta(N-t-C5H11)[N(CH3)2]3 |
| TBTEMT | Ta(N-t-C4H9)[N(C2H5)CH3]3 |
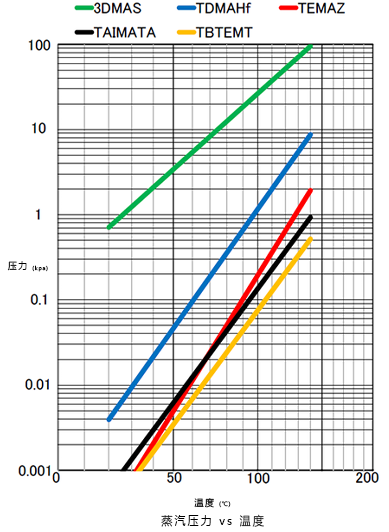
主要用在ALD上的卤化物的性质
| 化学式 |
|---|
| AlCl3 |
| MoCl5 |
| WCl6 |
| HfCl4 |
| ZrCl4 |
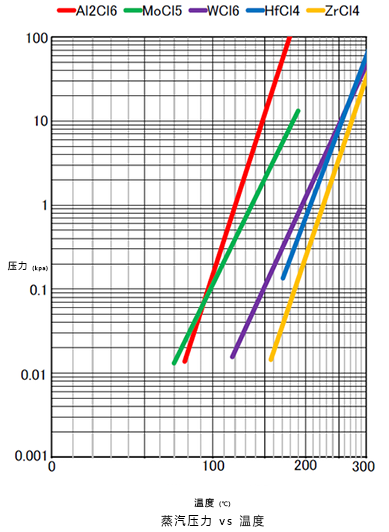
这里介绍的是在非易失性存储器的生产上所使用的铁电体MOCVD材料。
一般常见的有诸如dpm之类的β-二酮适用于Pb(Zr,Ti)O3(PZT),对于高电介质膜的Ta2O5,一般使用Ta(OC2H5)5。




用于形成高铁电极的材料特性表
※You can scroll and see
| 分子量 | 熔点 | 蒸汽压 | 比重 | 备注 | |
|---|---|---|---|---|---|
| Ta(OC2H5)5 PET CAS 6074-84-6 |
406.25 | 21℃ | log10P=12.645-4505/ (t+273.15) (P:Pa、t:℃) |
1.56 | 与空气中的水分发生水解反应。 |
| Hf(O-t-C4H9)4 HTB CAS 2172-02-3 |
407.94 | 8℃ | log10P=11.265-3052/ (t+273.15) (P:Pa、t:℃) |
1.17 | 与空气中的水分发生水解反应。 |
| Al(O-sec-C4H9)3 CAS 2269-22-9 |
246.32 | -60℃ | log10P=13.325-4698/ (t+273.15) (P:Pa、t:℃) |
0.937 | 与空气中的水分发生水解反应。 |
| Ru(C5H4C2H5)2 CAS 32992-96-4 |
287.36 | 6℃ | log10P=11.875-3708/ (t+273.15) (P:Pa、t:℃) |
1.56 | 空气中相对稳定。 |
| Pb(C11H19O2)2 CAS 21319-43-7 |
573.73 | 130℃ | 升华 log10P=20.545-7800/ (t+273.15) (P:Pa、t:℃) 蒸发 log10P=12.065-4480/ (t+273.15) (P:Pa、t:℃) |
1.52 | 空气中相对稳定。 |
| Zr(O-i-C3H7)(C11H19O2)3 CAS 343311-16-0 |
700.11 | >210℃ | log10P=19.735-7924/ (t+273.15)(P:Pa、t:℃) |
1.0 | 与空气中的氧气与水分发生反应,进行分解。 |
| Ti(O-i-C3H7)2 (C11H19O2)2 CAS 144665-26-9 |
532.58 | 160℃ | log10P=14.855-5435/ (t+273.15)(P:Pa、t:℃) |
1.0 | 与空气中的氧气与水分发生反应,进行分解。 |
